思來半導(dǎo)體完成12英寸碳化硅激光剝離量產(chǎn)設(shè)備規(guī)模化交付
近期,思來半導(dǎo)體(Silai Semicon) 已完成第三批兼容12 英寸碳化硅(SiC)襯底的激光剝離(LLO)量產(chǎn)設(shè)備交付。
公司核心研發(fā)團(tuán)隊(duì)源自華中科技大學(xué)激光科學(xué)專業(yè),具備強(qiáng)勁創(chuàng)新能力與多年激光行業(yè)深厚技術(shù)積累。針對(duì)莫氏硬度達(dá) 9.5、接近鉆石的碳化硅單晶,團(tuán)隊(duì)自主研發(fā)專屬激光剝離技術(shù),先后推出 6 英寸、8 英寸、12 英寸碳化硅襯底量產(chǎn)設(shè)備。
相較于行業(yè)現(xiàn)有方案,思來設(shè)備具備顯著技術(shù)差異化優(yōu)勢(shì):
業(yè)內(nèi)首創(chuàng)片上系統(tǒng)(SoC)集成光源架構(gòu),比傳統(tǒng)多光源方案集成度更高、穩(wěn)定性更強(qiáng)。
配備自由曲面光束整形技術(shù),以及 “白光干涉表面測(cè)量 + 逆向算法補(bǔ)償” 方案,保障高可靠性。
設(shè)備可支持不同電阻率碳化硅晶體的工藝定制,能承受更高能量負(fù)載,無老化、壽命無限制、抗干擾能力強(qiáng)。兼容 6/8/12 英寸襯底,定位精度高,可靈活適配非標(biāo)準(zhǔn)尺寸。設(shè)備占地面積僅 1.2 米 ×1.4 米,單機(jī)即可完成全流程切割與自動(dòng)上下料,大幅節(jié)省晶圓廠空間,同時(shí)實(shí)現(xiàn)全自動(dòng)化高性能運(yùn)行。
核心優(yōu)勢(shì):效率與成本大幅領(lǐng)先傳統(tǒng)工藝
該激光剝離工藝性能顯著優(yōu)于傳統(tǒng)線鋸切割:
產(chǎn)能:8 英寸晶圓激光剝離時(shí)間低于 15 分鐘,速度為傳統(tǒng)方式的 20–30 倍。
材料損耗:8 英寸晶圓損耗降至 60–80 微米,降低 60%。
無耗材與化學(xué)藥劑,無需消耗品。
晶圓產(chǎn)出提升 30%,單晶圓加工成本降低 50%。
不到半年時(shí)間,思來半導(dǎo)體已交付數(shù)十臺(tái)設(shè)備,應(yīng)用于國(guó)內(nèi)多家頭部碳化硅廠商。依托模塊化設(shè)計(jì)與產(chǎn)業(yè)協(xié)同,公司已實(shí)現(xiàn)規(guī)模化量產(chǎn),目前批量交付周期為 28 天,未來有望縮短至 14 天。
值得關(guān)注的是,思來半導(dǎo)體引入武漢帝爾激光科技股份有限公司等戰(zhàn)略投資方。帝爾激光是全球精密激光微納加工設(shè)備龍頭企業(yè),已推出多款先進(jìn)半導(dǎo)體解決方案。
雙方合作將進(jìn)一步強(qiáng)化思來在該關(guān)鍵領(lǐng)域的競(jìng)爭(zhēng)力。與此同時(shí),公司正拓展硅光核心設(shè)備,其自主研發(fā)的硅光芯片激光隱形切割設(shè)備已成功出口海外,有望成為未來旗艦產(chǎn)品之一。





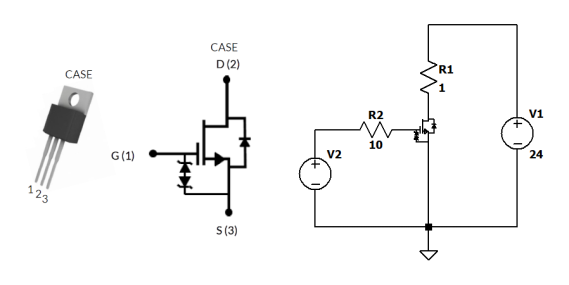



評(píng)論