沙子里長(zhǎng)出的奇跡:一文讀懂芯片
你手中的手機(jī)、每天辦公的電腦,甚至是家里的智能家電,它們的核心大腦都是芯片。但很少有人知道,這個(gè)撐起了數(shù)字時(shí)代的精密產(chǎn)物,最初居然只是毫不起眼的沙子。今天我們就一起走進(jìn)芯片的世界,從砂石到方寸算力之巔,看看芯片是如何誕生,又有著怎樣精妙的內(nèi)在構(gòu)造。

一、從沙子到芯片 —— 理解芯片的生產(chǎn)
點(diǎn)石成金的第一步:提純硅
從沙子到芯片的第一步,就是從石英砂中提取高純度硅,這一步就像給沙子“脫胎換骨”,去除雜質(zhì)、保留純凈的硅元素,為后續(xù)芯片制造打下基礎(chǔ)。
石英砂并不能直接變成芯片,第一步要做的就是“提純”。工廠會(huì)將石英砂放入溫度超過(guò)1800℃的高溫電弧爐中,加入碳元素進(jìn)行還原反應(yīng),去除石英砂中的氧元素,提煉出純度約98%的工業(yè)硅。不過(guò),此時(shí)的工業(yè)硅還像一塊“粗坯”,含有大量鐵、鋁、硼等雜質(zhì),無(wú)法用于精密的芯片制造。
接下來(lái)要進(jìn)行更精細(xì)的提純——西門(mén)子法。簡(jiǎn)單來(lái)說(shuō),就是先將工業(yè)硅轉(zhuǎn)化為三氯氫硅氣體,再通過(guò)多次精餾(類(lèi)似“蒸餾提純”的原理),將三氯氫硅還原為高純度的電子級(jí)多晶硅。這種多晶硅的純度高達(dá)99.999999999%(11個(gè)9),意味著100億個(gè)原子中,最多只能有1個(gè)雜質(zhì)原子,其純度遠(yuǎn)超我們?nèi)粘=佑|的任何物質(zhì),哪怕是醫(yī)用級(jí)別的高純度材料,也無(wú)法與之相比。這一步,就是把普通沙子“點(diǎn)石成金”的關(guān)鍵。
晶圓
高純度的多晶硅,還需要進(jìn)一步加工成“晶圓”——芯片的“載體”。工人會(huì)將多晶硅融化成熔融狀態(tài)的硅液,放入單晶爐中,再將一顆提前準(zhǔn)備好的“籽晶”(可以理解為“種子”)放入硅液中。通過(guò)“旋轉(zhuǎn)提拉法”,籽晶會(huì)以每分鐘幾毫米的緩慢速度向上提拉,硅原子會(huì)順著籽晶的晶格結(jié)構(gòu),一層一層整齊排列,最終形成一根完整的單晶硅棒。
單晶硅棒的直徑,決定了后續(xù)晶圓的尺寸。目前主流的晶圓尺寸是12英寸(約30厘米),一根12英寸的單晶硅棒,長(zhǎng)度可以達(dá)到2米以上,堪比一個(gè)成年人的身高。隨后,單晶硅棒會(huì)被金剛石鋸片切割成厚度僅0.75毫米左右的薄片——這就是硅片。
切割后的硅片表面會(huì)有劃痕和凹凸不平,需要經(jīng)過(guò)打磨和化學(xué)機(jī)械拋光,去除表面損傷,最終得到表面如鏡面般光滑的晶圓。它的表面平整度誤差不超過(guò)0.1納米,相當(dāng)于人類(lèi)頭發(fā)絲直徑的百萬(wàn)分之一——如果把晶圓放大到足球場(chǎng)那么大,它的表面最高處和最低處的差距,也不會(huì)超過(guò)一根頭發(fā)絲的粗細(xì)。
光刻與蝕刻:在晶圓上繪制電路
如果說(shuō)晶圓是芯片的“畫(huà)布”,那么光刻和蝕刻,就是在這張“畫(huà)布”上繪制精密電路的核心步驟——這也是芯片制造中最關(guān)鍵、最難的一步,被稱(chēng)為半導(dǎo)體產(chǎn)業(yè)的“皇冠上的明珠”,直接決定了芯片的精度和性能。
首先,工程師會(huì)在晶圓表面涂上一層“光刻膠”,這種材料遇到特定光線(xiàn)會(huì)發(fā)生化學(xué)性質(zhì)變化。隨后,使用光刻機(jī)(目前最先進(jìn)的是極紫外光刻機(jī)EUV),將設(shè)計(jì)好的芯片電路圖,通過(guò)極紫外光投射到光刻膠上。曝光后的光刻膠會(huì)變硬,形成一層可以抵抗蝕刻的“保護(hù)層”,而未曝光的部分則會(huì)保留柔軟的狀態(tài)。
目前最先進(jìn)的極紫外光刻機(jī),其光源能量是太陽(yáng)光的100萬(wàn)倍,能夠?qū)崿F(xiàn)0.5納米的制程精度——這個(gè)精度有多高?相當(dāng)于把一根頭發(fā)絲分成100萬(wàn)份,每一份的寬度,就是它的精度。這種超高精度,才能讓芯片上集成更多的晶體管,實(shí)現(xiàn)更強(qiáng)的算力。
光刻完成后,晶圓會(huì)被放入蝕刻機(jī)中。蝕刻機(jī)通過(guò)等離子體(一種高溫帶電氣體),將沒(méi)有被光刻膠保護(hù)的硅材料“腐蝕”掉,只留下被光刻膠覆蓋的部分,這樣一來(lái),晶圓表面就會(huì)出現(xiàn)精細(xì)的電路圖案。這個(gè)過(guò)程并不是一次就能完成的,需要重復(fù)幾十次甚至上百次,每一次的對(duì)準(zhǔn)精度都要控制在納米級(jí)別,稍有失誤,整片晶圓就會(huì)報(bào)廢,損失巨大。
摻雜與封裝:賦予芯片功能與保護(hù)
有了電路圖案的晶圓,還只是“半成品”,需要通過(guò)“摻雜”工藝,賦予它計(jì)算能力。摻雜的原理很簡(jiǎn)單:通過(guò)離子注入工藝,將磷、硼等雜質(zhì)離子加速到接近光速,精準(zhǔn)注入到晶圓的特定區(qū)域,改變半導(dǎo)體的導(dǎo)電性能,從而形成晶體管的源極、漏極和柵極——這三個(gè)部分,就是晶體管的“核心部件”,相當(dāng)于芯片的“最小計(jì)算單元”。
離子注入的精度要求極高,深度和濃度的誤差不能超過(guò)一個(gè)原子層,稍有偏差,晶體管就無(wú)法正常工作。完成摻雜后,晶圓會(huì)被送到測(cè)試機(jī)上,通過(guò)細(xì)小的探針,測(cè)試每一顆芯片的電氣性能,篩選出合格的芯片裸片(相當(dāng)于芯片的“核心裸板”),不合格的會(huì)被直接淘汰。
最后一步是封裝。封裝就像是給芯片“穿上一層堅(jiān)固的鎧甲”:首先通過(guò)金絲球焊工藝,將直徑僅20微米(比頭發(fā)絲還細(xì))的金線(xiàn),精準(zhǔn)焊接在芯片裸片的焊盤(pán)和封裝引腳之間;隨后,用環(huán)氧樹(shù)脂等耐高溫、防腐蝕的材料,將芯片裸片包裹起來(lái),形成我們?nèi)粘R?jiàn)到的芯片成品。
封裝不僅僅是保護(hù)作用,還承擔(dān)著散熱和電氣連接的功能——芯片運(yùn)行時(shí)會(huì)產(chǎn)生熱量,封裝材料可以幫助散熱,避免芯片因過(guò)熱損壞;而引腳則是芯片與外部設(shè)備(如手機(jī)、電腦主板)連接的“橋梁”,保障電信號(hào)和數(shù)據(jù)的傳輸。
二、深入了解 IC 內(nèi)部結(jié)構(gòu) —— 理解芯片的設(shè)計(jì)
5.2.1 金線(xiàn):芯片的神經(jīng)脈絡(luò)
金線(xiàn)是芯片內(nèi)部的“信號(hào)傳輸通道”,相當(dāng)于芯片的“神經(jīng)脈絡(luò)”,它的核心作用是連接芯片裸片和封裝引腳,快速傳輸芯片運(yùn)行時(shí)的電信號(hào)。金線(xiàn)的優(yōu)勢(shì)很明顯——導(dǎo)電性極佳、穩(wěn)定性強(qiáng),能確保電信號(hào)傳輸不延遲、不損耗,是目前芯片封裝中最常用的導(dǎo)線(xiàn)。

金線(xiàn)的焊接過(guò)程堪稱(chēng)“微觀級(jí)別的精密操作”:通過(guò)金絲球焊工藝,首先在芯片焊盤(pán)上,用高壓電弧將金線(xiàn)融化成一個(gè)微小的金球(直徑僅幾微米),隨后將金球精準(zhǔn)按壓在焊盤(pán)上,形成牢固的焊接點(diǎn);接著,將金線(xiàn)拉到封裝引腳的位置,再次焊接固定,整個(gè)過(guò)程的精度控制在微米級(jí)別,堪比“在針尖上跳舞”。
隨著芯片集成度越來(lái)越高(芯片上的晶體管數(shù)量越來(lái)越多),金線(xiàn)也逐漸面臨“空間不足”的問(wèn)題。因此,銅線(xiàn)和鋁線(xiàn)也開(kāi)始被廣泛應(yīng)用——它們的成本更低,且可以實(shí)現(xiàn)更高的傳輸密度,適合用于高端芯片的封裝。
5.2.2 晶圓:芯片的孕育溫床
晶圓是芯片的“孕育溫床”,所有芯片的制造,都要在晶圓上完成。一塊12英寸的晶圓,相當(dāng)于一張普通唱片的大小,上面可以同時(shí)制造數(shù)千顆芯片——就像在一張紙上印上很多相同的圖案,批量生產(chǎn)能大幅降低成本。

每一顆芯片在晶圓上都擁有獨(dú)立的電路單元,從光刻、蝕刻到摻雜,每一道工序都需要在無(wú)塵車(chē)間中進(jìn)行。無(wú)塵車(chē)間的要求極高,車(chē)間內(nèi)的塵埃顆粒直徑不能超過(guò)0.1微米,空氣質(zhì)量是醫(yī)院手術(shù)室的1000倍——因?yàn)槟呐率且活w微小的塵埃,落在晶圓上,都可能導(dǎo)致芯片電路短路,直接報(bào)廢。

當(dāng)晶圓完成所有制造工序后,會(huì)通過(guò)劃片機(jī)進(jìn)行切割。劃片機(jī)使用金剛石刀片,以每分鐘數(shù)萬(wàn)轉(zhuǎn)的速度高速旋轉(zhuǎn),將晶圓切割成一顆顆獨(dú)立的芯片裸片。這個(gè)過(guò)程既要保證切割精度,不能損傷芯片內(nèi)部的電路,又要提高效率,確保每一顆裸片都能正常使用。
Gold Bonding Wire: 半導(dǎo)體鍵合金線(xiàn)/金絲
用于半導(dǎo)體封裝工藝中的芯片鍵合。
Wire Bond/金線(xiàn)鍵合:指在對(duì)芯片和基板間的膠粘劑處理以使其有更好的粘結(jié)性能后,用高純金線(xiàn)把芯片的接口和基板的接口鍵合。
成分為金(純度為99.999%),摻雜銀、鈀、鎂、鐵、銅、硅等元素。
摻雜不同的元素可以改變金線(xiàn)的硬度、剛性、延展度、電導(dǎo)率等參數(shù)。

5.2.3 封裝:芯片的堅(jiān)固鎧甲
很多人以為封裝只是“給芯片套個(gè)殼”,其實(shí)不然——封裝是芯片不可或缺的一部分,承擔(dān)著機(jī)械保護(hù)、電氣連接、散熱三大核心作用,直接影響芯片的穩(wěn)定性和使用壽命。
不同的應(yīng)用場(chǎng)景,需要不同的封裝形式。比如我們常見(jiàn)的BGA封裝(球柵陣列封裝),擁有密集的引腳,能實(shí)現(xiàn)高速的數(shù)據(jù)傳輸,適合用于高性能處理器(如電腦CPU、手機(jī)SoC);而QFP封裝(四方扁平封裝),擁有扁平的引腳,更便于焊接,常用于一些通用芯片(如家電中的控制芯片)。
對(duì)于高性能芯片(如服務(wù)器芯片、顯卡芯片),封裝技術(shù)尤為重要。這類(lèi)芯片運(yùn)行時(shí)會(huì)產(chǎn)生大量熱量,普通的封裝無(wú)法滿(mǎn)足散熱需求,因此會(huì)采用液冷封裝技術(shù)——在封裝內(nèi)部加入冷卻液,通過(guò)冷卻液的循環(huán),快速帶走芯片產(chǎn)生的熱量,讓芯片可以在更高的頻率下穩(wěn)定運(yùn)行,發(fā)揮更強(qiáng)的性能。
先進(jìn)封裝
先進(jìn)封裝是“超越摩爾”(More than Moore)時(shí)代的一大技術(shù)亮點(diǎn)。當(dāng)芯片在每個(gè)工藝節(jié)點(diǎn)上的微縮越來(lái)越困難、也越來(lái)越昂貴之際,工程師們將多個(gè)芯片放入先進(jìn)的封裝中,就不必再費(fèi)力縮小芯片了。本文將對(duì)先進(jìn)封裝技術(shù)中最常見(jiàn)的10個(gè)術(shù)語(yǔ)進(jìn)行簡(jiǎn)單介紹。
2.5D封裝
先進(jìn)封裝是“超越摩爾”(More than Moore)時(shí)代的一大技術(shù)亮點(diǎn)。當(dāng)芯片在每個(gè)工藝節(jié)點(diǎn)上的微縮越來(lái)越困難、也越來(lái)越昂貴之際,工程師們將多個(gè)芯片放入先進(jìn)的封裝中,就不必再費(fèi)力縮小芯片了。本文將對(duì)先進(jìn)封裝技術(shù)中最常見(jiàn)的10個(gè)術(shù)語(yǔ)進(jìn)行簡(jiǎn)單介紹。
2 .5D封裝是傳統(tǒng)2D IC封裝技術(shù)的進(jìn)展,可實(shí)現(xiàn)更精細(xì)的線(xiàn)路與空間利用。在2.5D封裝中,裸晶堆棧或并排放置在具有硅通孔(TSV)的中介層(interposer)頂部。其底座,即中介層,可提供芯片之間的連接性。
2.5D封裝通常用于高端ASIC、FPGA、GPU和內(nèi)存立方體。2008年,賽靈思(Xilinx)將其大型FPGA劃分為四個(gè)良率更高的較小芯片,并將這些芯片連接到硅中介層。2.5D封裝由此誕生,并最終廣泛用于高帶寬內(nèi)存(HBM)處理器整合。
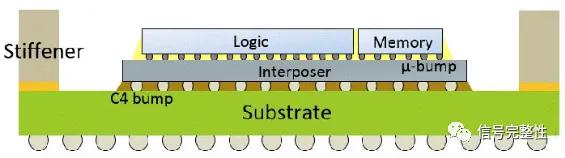
2.5D封裝示意圖
3D封裝
在3D IC封裝中,邏輯裸晶堆棧在一起或與儲(chǔ)存裸晶堆棧在一起,無(wú)需建構(gòu)大型的系統(tǒng)單芯片(SoC)。裸晶之間透過(guò)主動(dòng)中介層連接,2.5D IC封裝是利用導(dǎo)電凸塊或TSV將組件堆棧在中介層上,3D IC封裝則將多層硅晶圓與采用TSV的組件連接在一起。
TSV技術(shù)是2.5D和3D IC封裝中的關(guān)鍵使能技術(shù),半導(dǎo)體產(chǎn)業(yè)一直使用HBM技術(shù)生產(chǎn)3D IC封裝的DRAM芯片。
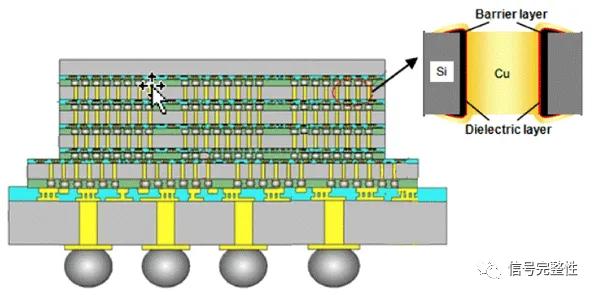
從3D封裝的截面圖可以看出,透過(guò)金屬銅TSV實(shí)現(xiàn)了硅芯片之間的垂直互連Chiplet
芯片庫(kù)中有一系列模塊化芯片可以采用裸晶到裸晶互連技術(shù)整合到封裝中。Chiplet是3D IC封裝的另一種形式,可以實(shí)現(xiàn)CMOS組件與非CMOS組件的異質(zhì)整合(Heterogeneous integration)。換句話(huà)說(shuō),它們是較小型的SoC,也叫做chiplet,而不是封裝中的大型SoC。
將大型SoC分解為較小的小芯片,與單顆裸晶相比具有更高的良率和更低的成本。Chiplet使設(shè)計(jì)人員可以充分利用各種IP,而不用考慮采用何種工藝節(jié)點(diǎn),以及采用何種技術(shù)制造。他們可以采用多種材料,包括硅、玻璃和層壓板來(lái)制造芯片。
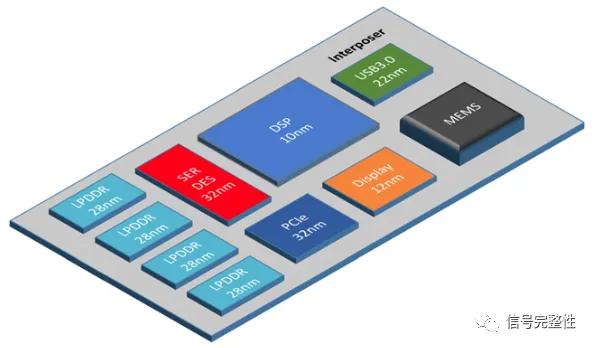
基于Chiplet的系統(tǒng)是由中介層上的多個(gè)Chiplet組成扇出(Fan Out)封裝
在扇出封裝中,“連結(jié)”(connection)被扇出芯片表面,從而提供更多的外部I/O。它使用環(huán)氧樹(shù)脂成型材料(EMC)完全嵌入裸晶,不需要諸如晶圓凸塊、上助焊劑、倒裝芯片、清潔、底部噴灑充膠和固化等工藝流程,因此也無(wú)需中介層,使異質(zhì)整合變得更加簡(jiǎn)單。
與其他封裝類(lèi)型相比,扇出技術(shù)提供了具有更多 I/O 的小尺寸封裝。2016 年,它使 Apple 能夠使用臺(tái)積電的封裝技術(shù)將其 16 納米應(yīng)用處理器與移動(dòng) DRAM 集成到 iPhone 7 的一個(gè)封裝中,從而成為技術(shù)明星。
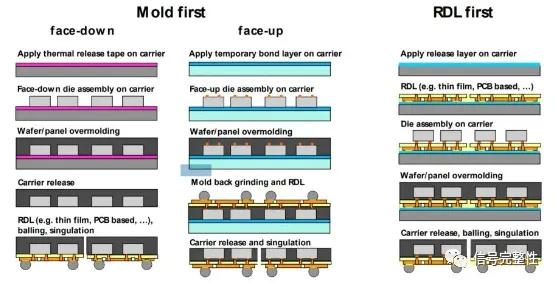
扇出封裝扇出晶圓級(jí)封裝(FOWLP)FOWLP技術(shù)是針對(duì)晶圓級(jí)封裝(WLP)的改進(jìn),可以為硅芯片提供更多外部連接。它將芯片嵌入環(huán)氧樹(shù)脂成型材料中,然后在晶圓表面建構(gòu)高密度重分布層(RDL)并施加焊錫球,形成重構(gòu)晶圓(reconstituted wafer)。
它通常先將經(jīng)過(guò)處理的晶圓切成單顆裸晶,然后將裸晶分散放置在載體結(jié)構(gòu)(carrier structure)上,并填充間隙以形成重構(gòu)晶圓。FOWLP在封裝和應(yīng)用電路板之間提供了大量連接,而且由于基板比裸晶要大,裸晶的間距實(shí)際上更寬松。
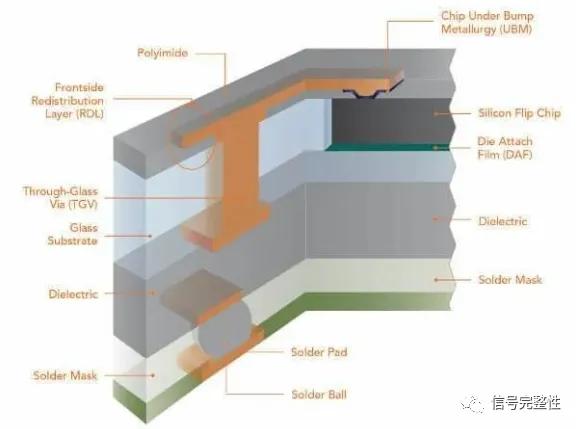
FOWLP封裝示例異質(zhì)整合將分開(kāi)制造的不同組件整合到更高級(jí)別的組件中,可以增強(qiáng)功能并改進(jìn)工作特性,因此半導(dǎo)體組件制造商能夠?qū)⒉捎貌煌に嚵鞒痰墓δ芙M件組合到一個(gè)組件中。
異質(zhì)整合類(lèi)似于系統(tǒng)級(jí)封裝(SiP),但它并不是將多顆裸晶整合在單個(gè)基板上,而是將多個(gè)IP以Chiplet的形式整合在單個(gè)基板上。異質(zhì)整合的基本思想是將多個(gè)具有不同功能的組件組合在同一個(gè)封裝中。
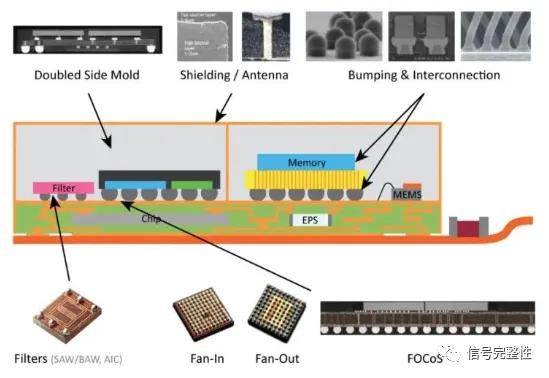
異質(zhì)整合中的一些技術(shù)建構(gòu)區(qū)塊HBMHBM是一種標(biāo)準(zhǔn)化的堆棧儲(chǔ)存技術(shù),可為堆棧內(nèi)部,以及內(nèi)存與邏輯組件之間的數(shù)據(jù)提供高帶寬信道。 HBM封裝將內(nèi)存裸晶堆棧起來(lái),并透過(guò)TSV將它們連接在一起,從而創(chuàng)建更多的I/O和帶寬。
HBM是一種JEDEC標(biāo)準(zhǔn),它在封裝內(nèi)垂直整合了多層DRAM組件,封裝內(nèi)還有應(yīng)用處理器、GPU和SoC。HBM主要以2.5D封裝的形式實(shí)現(xiàn),用于高端服務(wù)器和網(wǎng)絡(luò)芯片。現(xiàn)在發(fā)布的HBM2版本解決了初始HBM版本中的容量和時(shí)鐘速率限制問(wèn)題。

HBM封裝中介層
中介層是封裝中多芯片裸晶或電路板傳遞電信號(hào)的管道,是插口或接頭之間的電接口,可以將信號(hào)傳播更遠(yuǎn),也可以連接到板子上的其他插口。
中介層可以由硅和有機(jī)材料制成,充當(dāng)多顆裸晶和電路板之間的橋梁。硅中介層是一種經(jīng)過(guò)驗(yàn)證的技術(shù),具有較高的細(xì)間距I/O密度和TSV形成能力,在2.5D和3D IC芯片封裝中扮演著關(guān)鍵角色。
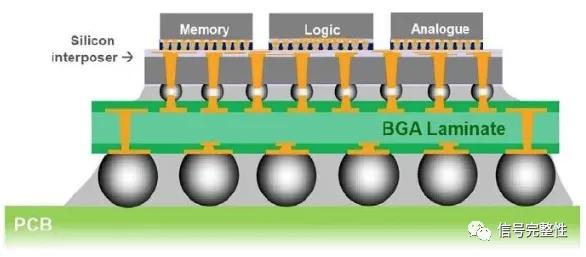
系統(tǒng)分區(qū)中介層的典型實(shí)現(xiàn)重分布層
重分布層包含銅連接線(xiàn)或走線(xiàn),用于實(shí)現(xiàn)封裝各個(gè)部分之間的電氣連接。它是金屬或高分子介電材料層,裸晶可以堆棧在封裝中,從而縮小大芯片組的I/O間距。重分布層已成為2.5D和3D封裝解決方案中不可或缺的一部分,使其上的芯片可以利用中介層相互進(jìn)行通訊。
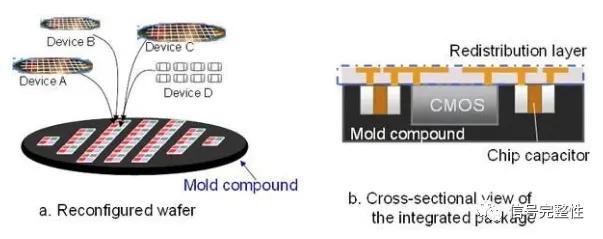
使用重分布層的整合封裝TSV
TSV是2.5D和3D封裝解決方案的關(guān)鍵實(shí)現(xiàn)技術(shù),是在晶圓中填充銅,提供貫通硅晶圓裸晶的垂直互連。它貫穿整個(gè)芯片以提供電氣連接,形成從芯片一側(cè)到另一側(cè)的最短路徑。
從晶圓的正面將通孔或孔洞蝕刻到一定深度,然后將其絕緣,并沉積導(dǎo)電材料(通常為銅)進(jìn)行填充。芯片制造完成后,從晶圓的背面將其減薄,以暴露通孔和沉積在晶圓背面的金屬,從而完成TSV互連。
5.2.4 工藝:芯片性能的幕后推手
我們常聽(tīng)到的7nm、5nm、3nm,指的就是芯片工藝(制程),它是決定芯片性能的“幕后推手”。簡(jiǎn)單來(lái)說(shuō),制程越小,意味著晶體管的尺寸越小,在同樣大小的芯片上,就能集成更多的晶體管——晶體管數(shù)量越多,芯片的算力就越強(qiáng),同時(shí)功耗也越低(更省電)。
舉個(gè)例子:從10nm工藝升級(jí)到7nm工藝,芯片的晶體管密度提升了一倍以上,功耗降低了30%左右——這就是為什么新款手機(jī)的芯片,比舊款更小、更省電,卻能實(shí)現(xiàn)更強(qiáng)的性能。先進(jìn)的芯片工藝,是一個(gè)國(guó)家半導(dǎo)體產(chǎn)業(yè)實(shí)力的核心體現(xiàn),它集合了材料科學(xué)、精密制造、光學(xué)、電子工程等多個(gè)領(lǐng)域的頂尖技術(shù),難度極高。
目前最先進(jìn)的3nm工藝,采用了全新的GAA(環(huán)繞柵極)晶體管結(jié)構(gòu)——傳統(tǒng)的晶體管是“平面結(jié)構(gòu)”,而GAA晶體管是“立體結(jié)構(gòu)”,能更好地控制晶體管的電流,減少電流泄漏,進(jìn)一步提升芯片的性能和能效比,為人工智能、高端計(jì)算等領(lǐng)域提供更強(qiáng)的算力支撐。
寫(xiě)在最后
芯片是現(xiàn)代科技的集大成者,從不起眼的沙子到驅(qū)動(dòng)數(shù)字世界的算力核心,每一顆芯片的誕生,都凝聚著無(wú)數(shù)工程師的智慧和心血,也承載著一個(gè)國(guó)家的科技實(shí)力。了解芯片的生產(chǎn)和設(shè)計(jì),不僅能讓我們看清數(shù)字時(shí)代的底層邏輯,更能明白科技發(fā)展背后的不易——每一步突破,都需要跨越無(wú)數(shù)技術(shù)難關(guān)。
隨著半導(dǎo)體技術(shù)的不斷進(jìn)步,未來(lái)的芯片將會(huì)擁有更加強(qiáng)大的算力、更低的功耗,體積也會(huì)更加小巧。它們將持續(xù)支撐人工智能、量子計(jì)算、自動(dòng)駕駛等前沿科技的發(fā)展,讓數(shù)字世界變得更加智能、更加便捷,而這一切的起點(diǎn),依然是那一粒平凡的沙子。
一個(gè)成功的芯片,其“突破點(diǎn)”往往是它在特定市場(chǎng)或技術(shù)領(lǐng)域脫穎而出的關(guān)鍵。這個(gè)突破點(diǎn)可以是技術(shù)上的、市場(chǎng)策略上的,或是商業(yè)模式上的。












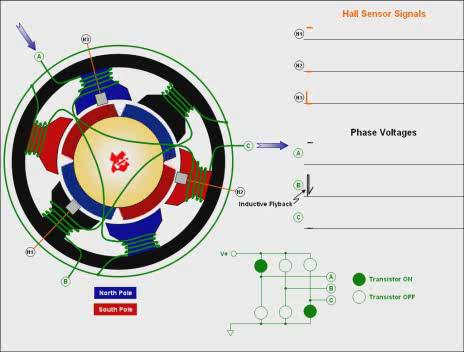
評(píng)論